GPモールド金型
さまざま成形方法により最先端パッケージに対応
精密加工技術がお客様のご要望にお応えします

精密加工によって製作する、耐久性や互換性に優れた高品質の金型をご提供いたします。
ピンポイントゲート成形方式(PPG)、油圧フローティングキャビティバー方式 (HFC)をはじめ当社が独自に開発したトランスファー圧縮成形システム「CCFC」など、多様なオプション機能を搭載可能です。お客さまのさまざまなニーズにお応えします。
トランスファー圧縮成形システム CCFC(Clamping Control Floating Chase)

トランスファー圧縮成形システム「CCFC(Clamping Control Floating Chase) 」は、トランスファー成形と圧縮成形のメリットを兼ね備えた当社独自の技術です。
樹脂の充填タイミングに応じて金型の上キャビティを可動させることで、通常のトランスファー成形では不可能な狭ギャップ薄型成形が行えるとともに、フィルムレスでの成形を実現したことでコストダウンに大きく貢献いたします。
また、キャビティ厚みチェンジング構造により、スペーサー交換によって、厚みの異なるQFNパッケージ製品を金型を変更することなく生産できるため、金型への投資コストを抑え、かつ金型交換のロス時間を短縮することができます。
油圧フローティングキャビティバー方式 HFC(Hydraulic Floating Cavity bar)
HFCによるBGA基板の厚みバランスの吸収は、スプリング式やコッター式では解決できない問題への唯一のソリューションです。
油圧上下可変式キャビティーバーにより、最適なクランプを行います。ソフトクランプによる高圧クランプの制御も可能です。
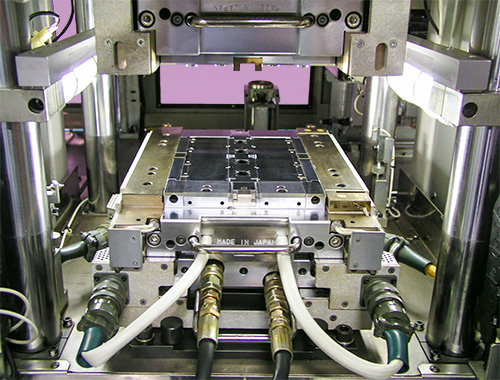
ピンポイントゲート成形方式 PPG(Pin Point Gate Molding)

PPGは、ワイヤー流れ対策が必要となる狭ピッチワイヤー製品へのソリューションだけにとどまらず、フレームの高密度化への対応にも必要とされる特殊技術です。
Dual Pot Mold Chase
Dual Potによって、大型モジュール成形で必要とされる大径樹脂の使用が可能になります。また、溶融安定性に優れたミニタブレットを選択することもでき、ワイヤー流れを抑制できます。
樹脂投入による金型のヒートロスを管理するカルヒーター(特許取得済)によりボイド発生を防ぎます。
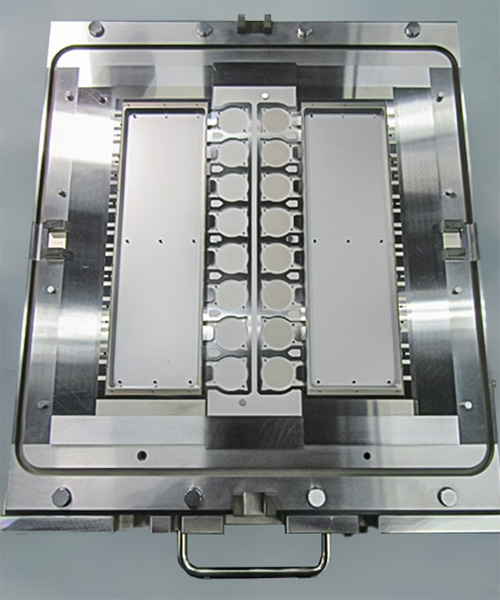
VAM(Vacuum Assisted Molding)

積層ダイパッケージに代表される新しいタイプのパッケージの成形において、 VAMテクノロジーはキャビティー内を減圧し樹脂を注入することで、ボイドや未充填を防ぎます。
FAM(Film Assisted Molding)
ダイ露出パッケージに代表されるセンサー成形やパワーデバイスなどのヒートシンク露出成形は、フィルムを使用するFAMテクノロジーにより実現いたします。
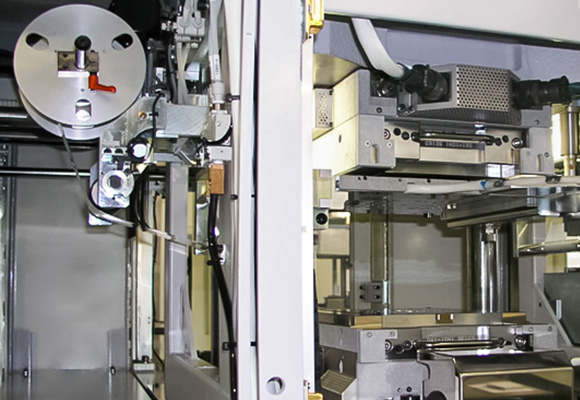
HDLF(High Density Leadframe Molding)
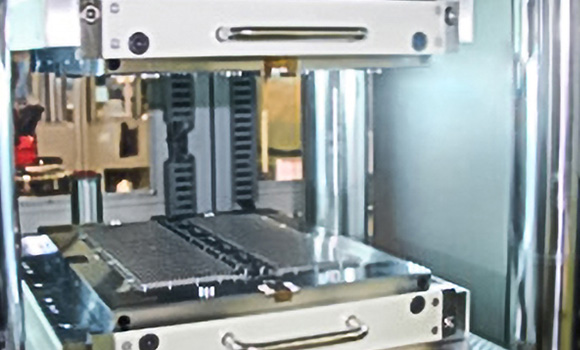
フレームの高密度化は拡大を続け、市場ではより大型フレームへの対応が要求されています。
SPシリーズでは80トン、120トン、170トンをそろえ、最大110mm×300mmサイズのフレームまで対応可能です。
4SPC(4 Strips per chase Molding)
今お使いの細幅のリードフレームを、1チェスに4枚を配置し成形するコンセプトで有効活用できます。
他の工程を改造することなく、生産数の増加が可能です。
(最大リードフレームサイズ:31mm×270mm)
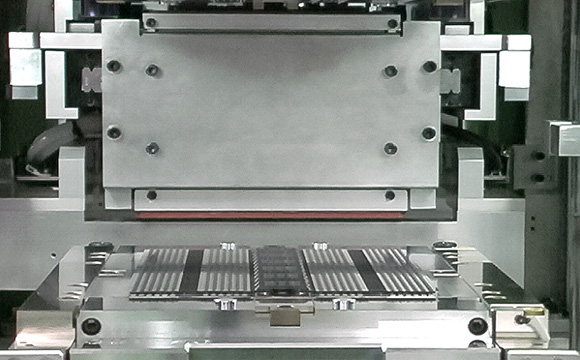
関連製品
半導体封止装置
-
GP-PRO SPシリーズ
大量生産に適したオートモールドシステムです。
信頼性を高めるために徹底した粉塵対策を施し、民生用ICから車載用ICや受動部品まで幅広い高品質ニーズに対応します。
-
GP-PRO sfシリーズ
多品種少量生産に特化した小型フルオートモールドシステムです。
1枚取りのsf40、2枚取りのsf120の2機種をラインナップしています。
-
GP-PRO saシリーズ
リードフレームと樹脂を金型に自動搬送し、成形まで自動で行います。
成形後の製品取り出しはマニュアルで行う2枚取りのセミオートモールドシステムです。
-
GP-PRO LABシリーズ
開発用途から特殊なアプリケーションへの対応まで幅広いオプションを揃えるマニュアルモールドシステムです。

-
S・Pot
コンパクトサイズの金型を使用し取り扱いも簡単な、デバイス開発向けの卓上小型成形機です。
試作成形を短期闇、低価格で実現し、新たなパッケージ開発に柔款に対応します。
